在我们的社群有问到“减薄工艺与CMP”方面的问题。表面去年,CMP也有减薄的作用,但其实不太一样,另外还有一个磨削研磨的工艺,可能也会有所误解。下面我们放在一起来聊一聊。
为了更直观的展现这几个工艺的不同,我们先看看它们在制造流程中的位置,画了一个包含部分流程的示意图,如下。

图中的黄色底是磨削/研磨工艺,绿色背景的是CMP平坦化工艺,红色底的是减薄工艺。可以看出,在流程顺序上,它们几个是有差异的,先有磨削/研磨再是CMP(重复多次),最后才是减薄。其中CMP平坦化工艺可以先看看我前面写的文章:为什么需要CMP工艺?,平坦化CMP用的次数比较多,在离子注入后的硅片表面,每一层金属化、以及对顶层金属进行抛光等地方都需要。而磨削研磨,主要目的是减少硅片的厚度。这里要注意削和研磨其实也是两个概念,通常是按照从粗糙到精细的顺序进行的,即先进行磨削,然后进行研磨。磨削是为了达到所需的尺寸或形状,研磨是为了去除磨削过程中留下的划痕和表面缺陷,就这么简单。另外特别再说一下:磨削是磨的晶圆背面,研磨则是对整个晶圆抛光,大部分是对晶圆正面进行抛光,多是物理方法。CMP在这里我们还是再提一句,CMP平坦化是在每次金属层沉积和蚀刻之后进行,使用化学腐蚀和机械研磨。在晶圆制造过程中,CMP可能需要多次进行,主要集中在晶圆正面。最后来说减薄工艺,顾名思义,它的目的也很简单,就是希望减少晶圆的整体厚度,从而提高集成度、减少热阻、适应封装要求等。这个操作流程是在晶圆正面所有制造步骤完成后,对整个晶圆进行的一次性操作,但这个操作是在晶圆切割成单个芯片之前。
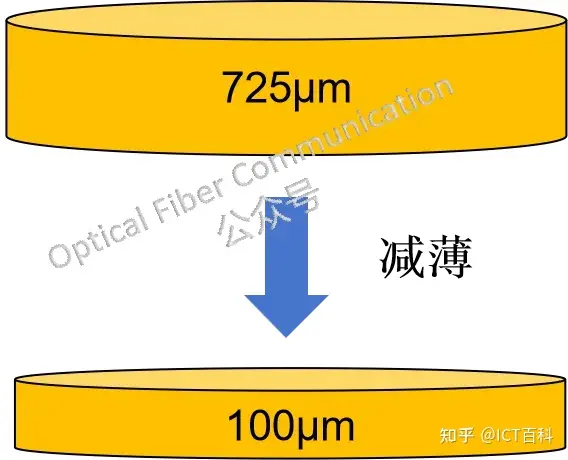
因此,可以看出减薄工艺与CMP工艺是不同的,与上面的研磨也不太一样,更有点像是磨削。通常我们是用含有金刚石磨粒的砂轮以一定的速度来磨削,如下面的图:

再画一个砂轮减薄的示意图,我画的图可能不太好看哈。
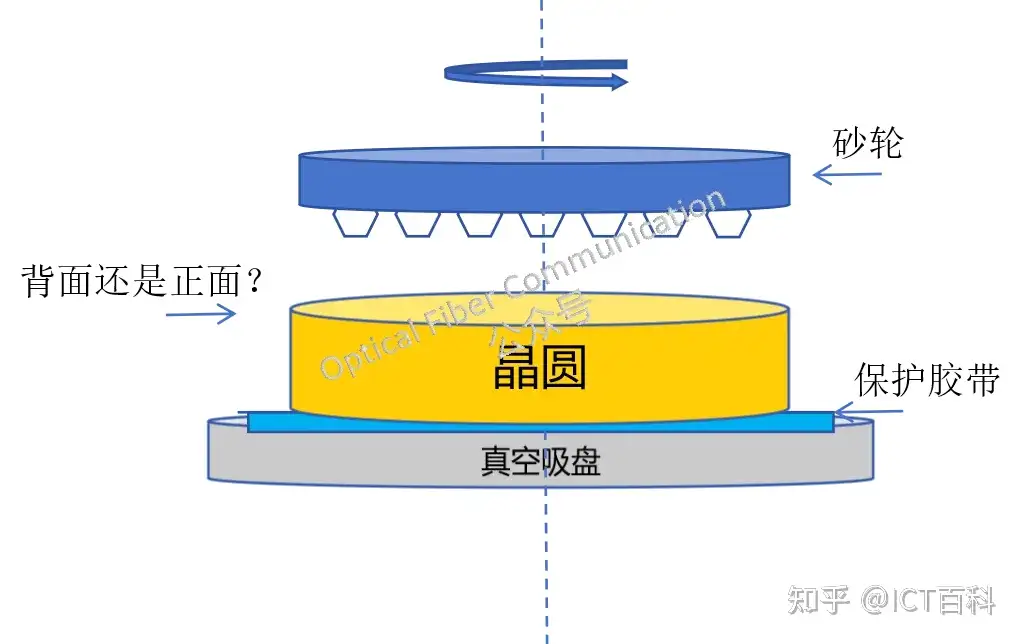
最后提一个小问题,减薄是针对晶圆的哪一面进行操作的:背面还是正面?欢迎留言!感谢阅读!
经OFC授权发布!