反应离子蚀刻,也叫 RIE (Reactive Ion Etching),是半导体制造中在薄膜上刻出结构的一种工艺。
RIE 既能做各向同性刻蚀(各个方向刻得差不多),也能做各向异性刻蚀(主要往下刻),如下面的示意图。具备这种能力是因为 RIE 结合了化学反应和物理轰击。
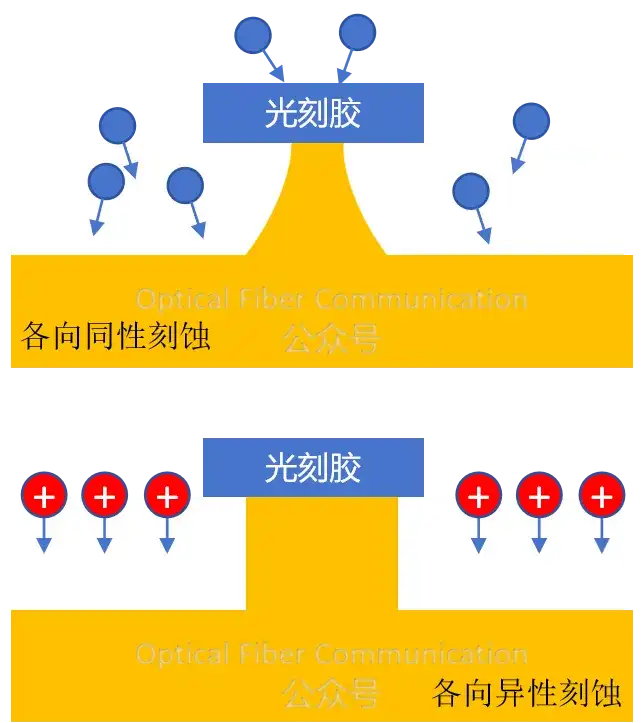
简单描述一下工艺:晶圆置于工艺腔的高频电极上。气体电离产生等离子体,包含自由电子和正离子。当高频电极瞬时带正电时,电子被吸引至其表面并积聚,形成高负电荷,即偏置电压。质量较大的离子响应滞后,在平均电场作用下被带负电的该电极吸引。
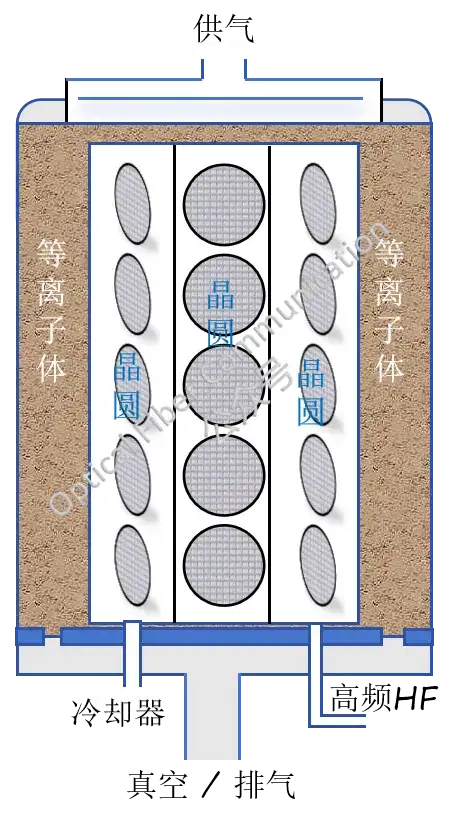
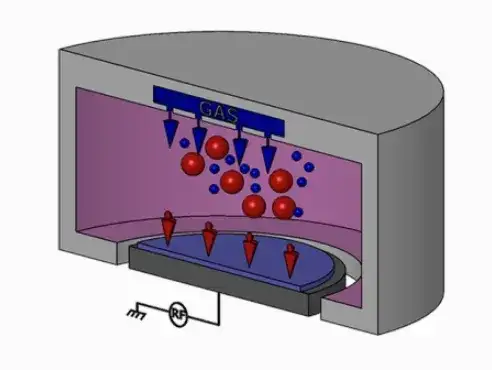
如果这些离子平均自由程比较长(碰撞前飞得远),它们就会差不多垂直地撞上晶圆表面。这一撞有两个作用:
第一,高速离子直接把表面的材料“打”下来(物理溅射); 第二,等离子体里的活性化学物质(自由基)也会和表面材料起反应(化学刻蚀)。
因此RIE有时也被称为离子增强蚀刻或反应和离子蚀刻。
因为离子基本上是垂直撞下来的,晶圆侧壁不会被直接打到,也就避免了往旁边刻,这样就刻出了垂直陡峭的形状(各向异性)。
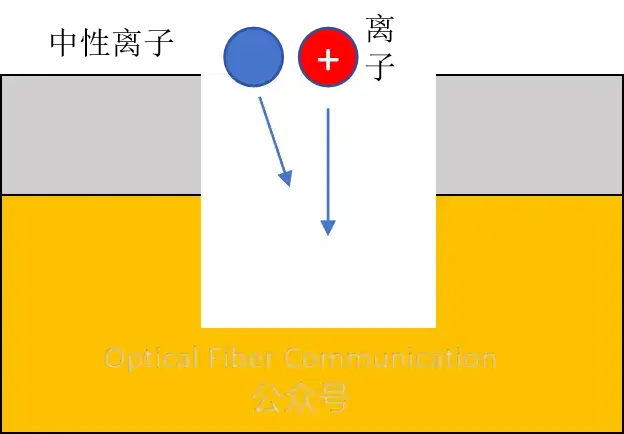
RIE 的选择性通常中等。物理溅射虽然帮了垂直刻蚀的忙,但它不太挑材料,这限制了化学刻蚀可能达到的高选择性。另外要注意,高能离子轰击可能会损伤晶圆表面,这种损伤通常后面要用热退火来修。
刻硅的时候,为了达到高各向异性,常用一个技巧叫“侧壁钝化”。
具体做法是在刻蚀过程中通点氧气 (O₂)。氧气会和从硅表面溅出来的硅原子在侧壁那里反应,生成一层很薄的二氧化硅 (SiO₂)。这层二氧化硅像保护层一样盖在垂直侧壁上,挡住了横向的化学刻蚀。在水平的底部,持续的离子轰击会把这层氧化膜不断打掉,这样刻蚀就能一直往下走。
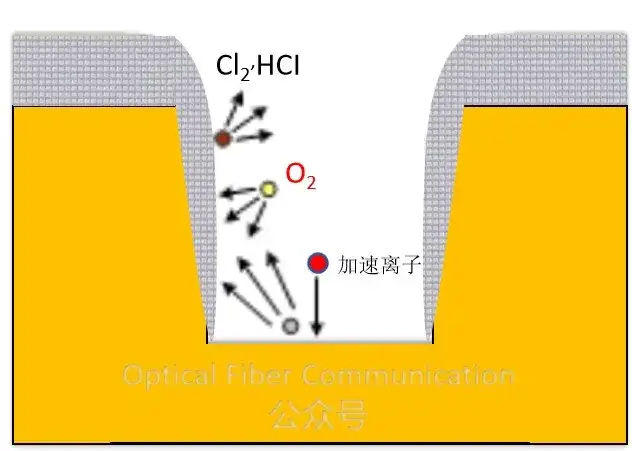
刻蚀速度受很多因素影响,像腔体压力、加到高频电极上的功率、用的工艺气体种类、气体流量大小、还有晶圆的温度。刻蚀的各向异性程度通常会随着高频功率加大、腔体压力降低、或者晶圆温度降低而变强。
最后,选择性和刻蚀速度很大程度上看你选哪种工艺气体。刻硅和它的化合物(像二氧化硅、氮化硅),主要用含氟(比如 CF₄, SF₆)和含氯(比如 Cl₂, BCl₃)的气体。
感谢阅读!
我们可提供多种速率的AOC/DAC/MPO线缆、光模块及光收发器以及应用于其中的各类光学元件,如非球面透镜、准直透镜、非球面透镜阵列、波片等,并可提供定制开发服务,欢迎联系微信OFC2025,邮箱:mark@bitwavx.com。