什么是刻蚀
在半导体制造的奇妙世界里,有一种技术如同一位隐形的英雄,默默地将光刻胶上的精细图案精准地转移到下层材料上,它就是刻蚀技术。这项技术,就像一位精湛的雕刻家,用物理或化学的“刻刀”,在硅片表面雕刻出千变万化的图形。
想象一下,光刻胶层上承载着设计好的电路图案,它们就像待雕刻的玉石,等待着刻蚀技术的精细加工。
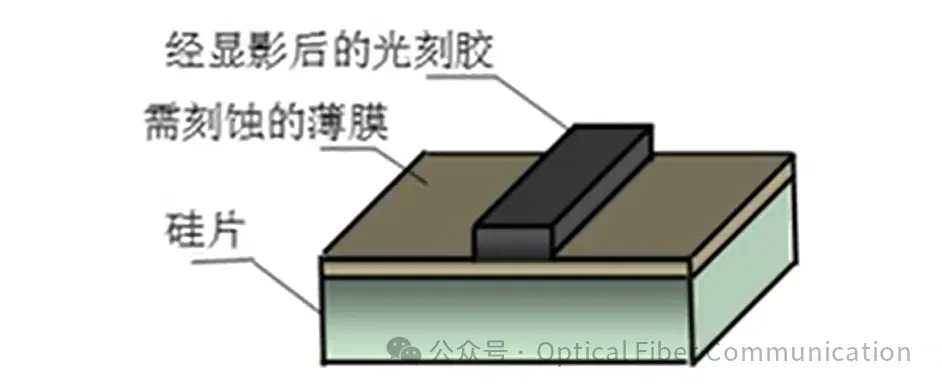
图-未经刻蚀的衬底
而刻蚀技术,就是那位能够将这些图案精确复制到下层薄膜材料的“艺术家”。经过它的处理,原本隐藏在光刻胶下的薄膜层变得清晰可见,只留下与光刻胶图形精确对齐的部位,其余部分则被巧妙地去除。
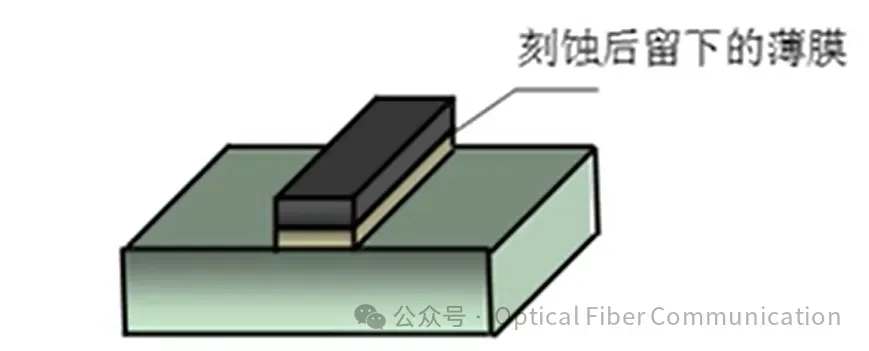
图-经刻蚀后的薄膜
那么,这位“艺术家”是如何工作的呢?这就涉及到了刻蚀工艺的几个核心参数,我们列出如下:
- 刻蚀速率
- 刻蚀因子
- 刻蚀选择比
- 刻蚀均匀性
- 刻蚀洁净度
刻蚀速率
首先,我们来看看刻蚀速率。它就像是雕刻家的手速,过快可能导致图形粗糙,过慢则影响效率。刻蚀速率通常正比于刻蚀剂的浓度。硅片表面几何形状等因素都能影响硅片与硅片之间的刻蚀速率。要刻蚀硅片表面的大面积区域,则会耗尽刻蚀剂浓度使刻蚀速率慢下来;如果刻蚀的面积比较小,则刻蚀就会快些。

通过测量刻蚀前后的薄膜厚度,将差值除以刻蚀时间就能计算出刻蚀速率:
刻蚀速率=(刻蚀前厚度-刻蚀后厚度)/刻蚀时间
刻蚀因子蚀各向异性因子决定了“雕刻”的方向性,它让刻蚀过程更倾向于在垂直方向上进行,从而形成陡峭的侧壁。该参数表征刻蚀在不同方向上的速率差异。
通常期望在垂直方向(深度方向)具有较高的刻蚀速率,形成垂直侧壁,体现为各向异性刻蚀。相反,若刻蚀在纵向和横向的速度相当,则被称为各向同性刻蚀。

刻蚀因子F定义为:当刻蚀线条时,亥刻蚀的深度V与一边的横向增加量△X的比值。
F=V/△X
刻蚀选择比
图形化刻蚀通常包含三种材料:光刻胶、被刻蚀的薄膜及衬底。刻蚀过程中,这三种材料都会受刻蚀剂的化学反应或等离子体刻蚀中离子轰击的影响。不同材料之间的刻蚀速率差就是所谓的选择比。
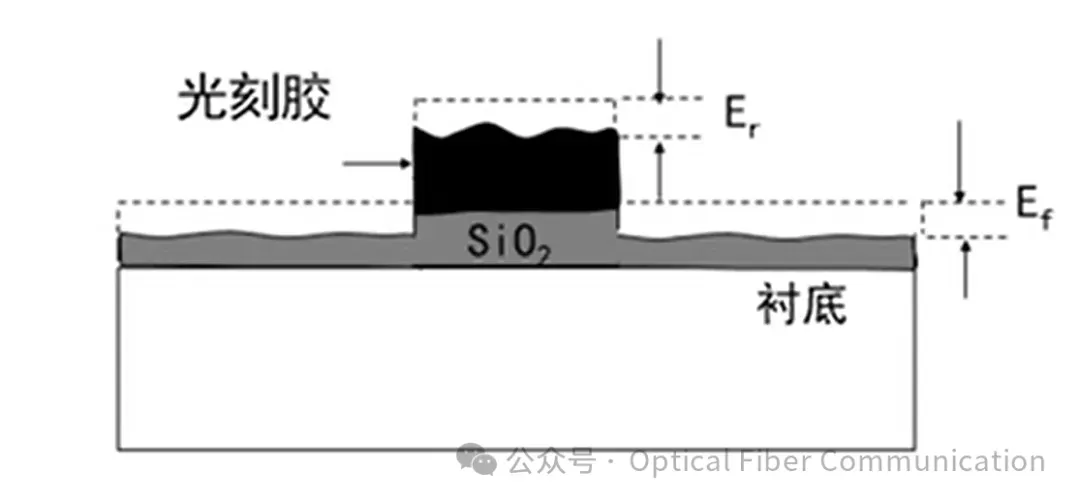
刻蚀选择比定义为:被刻蚀材料的刻蚀速率Ef与另一种材料如光刻胶/衬底的刻蚀速率Er的比值。

如果一个目标材料被刻蚀的速度是掩膜或衬底材料的10倍,那么刻蚀选择比就是10:1。
选择比是刻蚀技术中的“智慧”体现。它让刻蚀剂能够聪明地分辨出哪些是需要去除的材料,哪些是需要保留的部分,从而实现精准去除。这就像一位雕刻家能够准确地判断出哪些部分需要雕刻,哪些部分需要保留一样。
刻蚀均匀性
理想的刻蚀工艺应当保证在晶圆层面、同一批处理内部及不同批次之间的高度均匀性。刻蚀均匀性又分为片内均匀性、片间均匀性和批间均匀性。均匀性通常由测量刻蚀前后晶圆的特定点厚度,如在晶圆的中心、边缘,边缘与中心之间,并计算这些点的刻蚀速率得出。点的选取一般为在一批中随机抽取3~5片晶圆,在每片晶圆上选择5~9个点。

均匀性非常重要,在芯片制程的每一个工序中都需要考虑到,包括薄膜沉积,刻蚀,光刻,cmp,离子注入等。较高的均匀性才能保证芯片的产品与性能。
刻蚀洁净度
刻蚀洁净度很好理解。在刻蚀工序中,必须严格控制洁净度,确保无杂质、聚合物或颗粒污染物遗留。任何此类污染都有可能对后续工艺步骤产生不利影响。
相关下载:
……..